金属硅化物具有优异的高温抗氧化性以及良好的导电、导热性,已广泛应用于半导体制造中作为优良的接触材料[1-2]。随着金属硅化物的不断发展,主导的硅化物已从钛、钴硅化物逐步发展到低电阻、低耗硅量以及低形成温度的镍硅化物。研究表明,高温下NiSi 相易转化成NiSi2 稳定相,导致界面粗糙,电阻升高[3]。添加一定量的铂能提高NiSi 的高
温稳定性,改善NiSi 界面形貌,使之适应于精密的接触与互连工艺[4-5]。
目前制备镍铂硅化物薄膜的主流方法是首先在半导体衬底的硅区域形成离子注入层,再在其上制备一层硅外延层,随后采用磁控溅射法在硅外延层的表面溅射一层NiPt 薄膜,最后通过退火处理形成镍铂硅化物薄膜。
1、镍铂硅化物薄膜在半导体制造中的应用
1.1 在肖特基二极管制造中的应用
镍铂硅化物薄膜在半导体器件中的一个典型应用就是肖特基二极管。肖特基二极管是一种利用金属与N 型半导体接触形成势垒,从而具有整流特性的金属-半导体器件,广泛应用于开关电源、变频器、驱动器等电路中。随着肖特基二极管工艺不断发展,金属硅化物-硅接触已取代了传统的金属-硅接触,避免了表面缺陷与沾污,降低了表面态的影响,提
高了器件的正向特性、反向耐压、反向能量冲击、耐高温、抗静电、抗烧毁能力[6]。镍铂硅化物是目前较为理想的肖特基势垒接触材料,一方面镍铂合金作为势垒金属,具有良好的高温稳定性;另一方面可以通过合金成分配比的改变实现势垒高低的调整。图1 为一种肖特基二极管芯片示意图,其中势垒层3 的厚度大约为80 nm[7]。势垒层的制备方法是通过磁控溅射在N型硅半导体衬底上溅射镍铂合金层,并且460~480℃范围内真空退火30 min 左右形成NiPtSi-Si 势垒层。通常还需要溅射NiV、TiW等扩散阻挡层,阻挡金属间的互扩散,提高器件的抗疲劳性能。

由于肖特基势垒对界面元素的敏感依赖性,界面成分的分布变化将会对肖特基势垒高度产生影响。例如,Thomas 等人[8]发现NiPtSi-nSi 势垒高度介于NiSi-nSi(势垒高度0.65 eV)与PtSi-nSi(势垒高度0.85 eV)之间,且NiPtSi-nSi 势垒高度ΦB 随Ni-Pt合金薄膜中Pt 含量的增加而增加,并推断势垒高度ΦB 很可能与界面Pt 含量有关(如图2 所示),其中
Pt 含量的误差棒对应根据相应沉积参数与成分分布计算出的薄膜中的铂含量差异。Xu[9-10]等通过理论计算证明了镍铂合金表层铂原子浓度将显著影响其功函数,因此随界面Pt 含量的增加,合金功函数增加,导致势垒高度增加。

人们通过对镍铂合金成分配比的调整,控制势垒层的势垒高度,开发了一系列不同势垒高度的肖特基二极管,如低势垒高度的肖特基二极管,可应用于低激励混频器,同时也是热成像系统的最主要器件[11]。
1.2 在半导体集成电路中的应用
镍铂硅化物还广泛用于超大规模集成电路(VLSI)微电子器件中源、漏、栅极与金属电极间的接触[12-13]。目前,Ni-5%Pt(摩尔分数)已成功应用于65 nm 技术,Ni-10%Pt(摩尔分数)应用于45 nm 技术。随着半导体器件线宽的进一步减少,很有可能需要进一步提高镍铂合金中的Pt 含量来制备NiPtSi接触薄膜,其原因主要是合金中Pt 含量的增加能够提高薄膜的高温稳定性并且改善界面形貌、减少侵占缺陷[14]。通常磁控溅射于相应硅器件表面的镍铂合金薄膜层厚度仅10 nm 左右,形成镍铂硅化物所采用的方法为一步或多步快速热处理,温度范围为400~600℃,时间30~60 s。
近年来,人们采用原子探针层析技术(APT),研究不同Pt 含量镍铂合金薄膜经快速热处理后的相形成以及Pt 原子分布情况[15-16]。硅化过程采用不同处理工艺,界面处可能形成θ-Ni2Si、NiSi 以及δ-Ni2Si 相,Pt 原子在其中的固溶度依次递减。尤其是Pt 原子由于在δ-Ni2Si 相中固溶度较小而产生偏析集中在上表面,只有少部分在下表面(即与硅接触
内表面)。其中向下表面即NiPtSi/Si 内表面偏析的Pt 原子有利于消除侵占缺陷,而在上表面则会造成NiPtSi 薄膜的阻抗增加[17],有研究在半导体衬底掺杂As、B、S、In 等,通过元素偏析降低肖特基势垒从而降低接触电阻[16, 18-19]。而为了减小镍铂硅化物整体的阻抗,IBM 的专利采用两步骤制造NiPtSi薄膜:第一步溅射沉积Pt 含量较高的镍铂合金薄膜,第二步溅射沉积Pt 含量较低的镍铂合金薄膜甚至不含Pt 的纯镍薄膜。这样形成的镍铂硅化物薄膜上表面的Pt 含量低,有助于减小镍铂硅化物整体的阻抗;而下表面的Pt 含量高,利于减少或消除侵占缺陷[20]。因此在新的技术节点里,有可能依次采用不同Pt 含量的镍铂合金溅射靶材来制备具有梯度结构的镍铂硅化物接触薄膜。
2、镍铂合金结构与性质研究
对镍铂合金结构与性质的研究,是制备高质量镍铂合金靶材的基础。镍和铂能以任何混合比例形成稳定的面心立方结构固溶体,而且在相应成分、温度范围内存在类似于Cu-Au 体系相似的有序无序转变,Ni-Pt 体系相晶体结构数据如表1 所示,镍铂合金相图如图3 所示[21]。
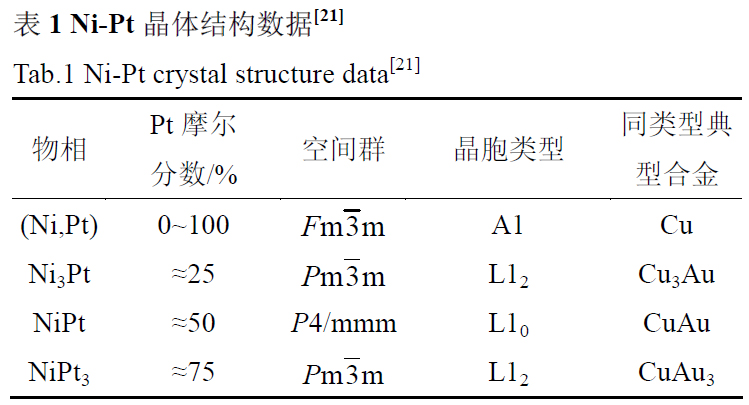
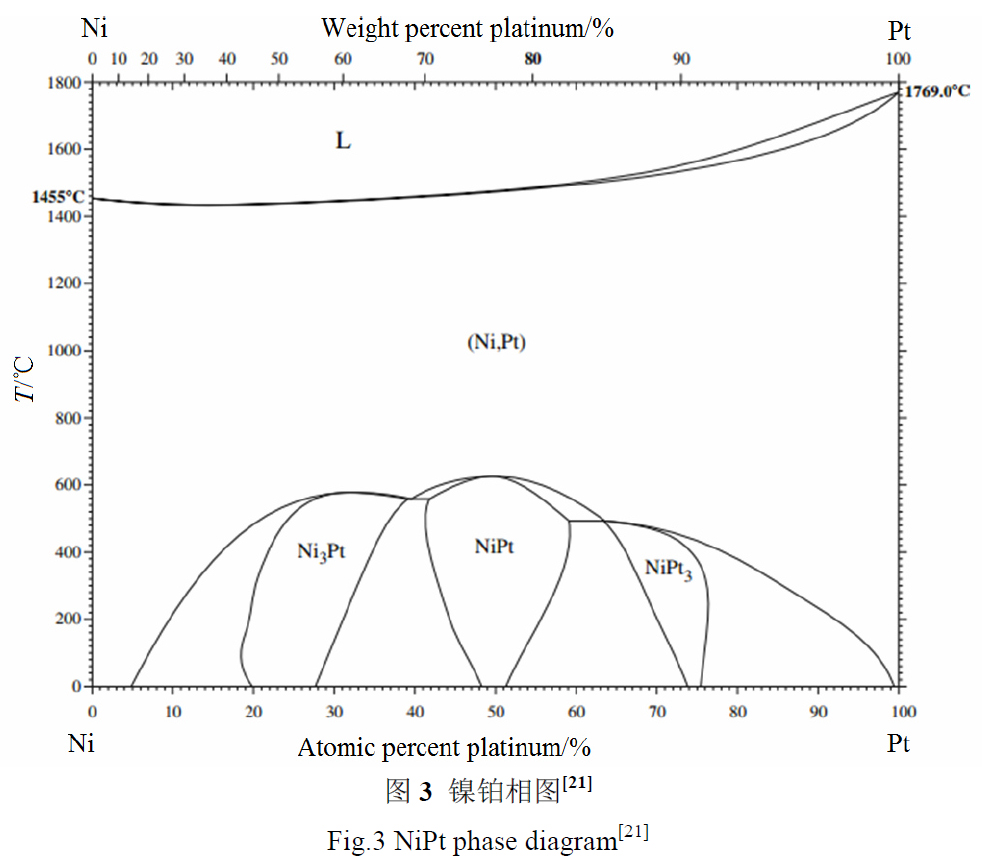
满足一定原子配比的镍铂合金在相应临界温度以下形成L12Ni3Pt、L10NiPt、L12NiPt3 三种有序相,前两者的临界温度分别是580、645℃。然而完全有序需要在较低温度下长时间退火处理才能得到(等原子比镍铂合金在610℃退火54 天或者在更低温度400℃退火长达135 天才能获得完全有序)[22],通过理论计算以及实验研究,研究者们还对镍铂合金的
热稳定性、有序转变动力学、有序参数等进行了研究[22-25]。
关于镍铂合金的磁学性质的研究,也是一直以来人们不断争论研究的热点,且对镍铂靶材的质量有着重要意义。Ni 与Pt 同属过渡族金属,其中Ni表现为铁磁性,Pt 表现为顺磁性,Ni-Pt 合金的磁性源于未被电子填满的Ni 3d 与Pt 5d 电子轨道相互作用,合金中Ni 的磁矩十分脆弱,易受近邻原子影响,面心立方结构中1 个Ni 原子近邻至少得有6个Ni 原子才能维持其磁性,因此随Pt 含量的增加,Ni-Pt 合金磁性减弱,由铁磁性向顺磁性转变,磁性转变的临界成分约为42.5%Ni(摩尔分数),然而在临界成分附近如等原子比镍铂合金,决定其磁性的主要因素为晶体结构。研究表明,无序状态的镍铂合金呈铁磁性,而有序状态的L10NiPt 呈顺磁性[26],这是由于L10NiPt 相发生四方畸变使Ni 原子之间间
距增大,导致局域磁矩消失。另外,在0%~31%Pt(摩尔分数)范围内,随着含量的增加,居里转变温度满足Tc=354.3-9.413XPt 线性降低[27]。
3、镍铂合金靶材的制备方法
靶材制备方法主要为熔炼法和粉末冶金法[28],镍铂合金靶材的传统制备的方法是粉末冶金法,将高纯Ni 粉与Pt 粉烧结成合金块体再进行后续加工,此方法相比于熔炼法可使镍铂合金获得更好的可加工性,但致密度难以满足要求并且制备过程中易混入杂质,尤其是气体杂质混入将引起溅射过程中异常放电现象[29]。目前通常使用真空熔炼法来制备镍
铂合金靶材,真空熔炼法包括真空感应熔炼和真空电子束熔炼等方法,为了获得杂质含量低(尤其气体成分)、高致密且成分均匀的合金铸锭,熔炼后的铸锭需要一次或多次精炼,以真空电子束熔炼为例,熔体中饱和蒸气压较高的杂质元素如Cu、Mg、Al等被迅速挥发到气相中并被抽真空带到炉体外,在反复精炼中逐渐达到提纯的目的。同时,精炼也避
免了气体在铸锭凝固初期形核,并在随后连续冷却过程中长大而形成疏松、气孔、缩孔等铸造缺陷[30]。
真空熔炼所获得的铸锭还需要进一步塑性加工、热处理和机械加工,与铜背板焊合,经超声检测、清洗真空包装等步骤,才能获得合格的靶材产品,具体流程如图4 所示。
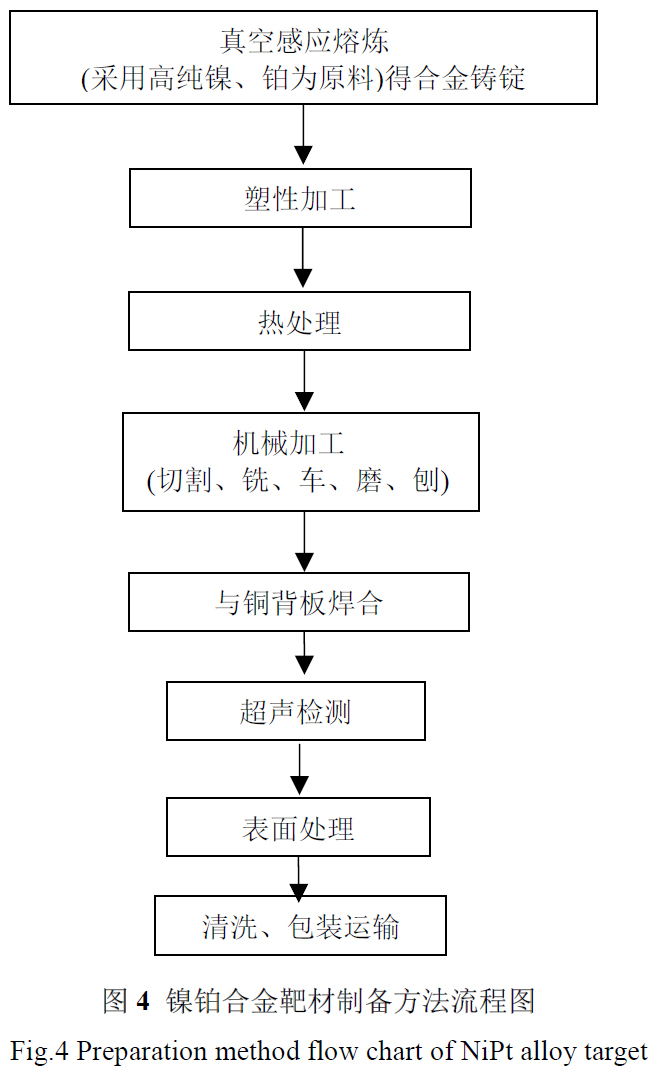
为了获得高质量的镍铂合金靶材,除了纯度、致密度满足要求之外,组织均匀、晶粒尺寸及晶粒取向也是影响最终镀膜质量的关键因素。镍铂合金靶材微观组织结构主要由塑性加工与热处理相结合的手段来控制。通常先将镍铂合金铸锭热锻成块或者采用热轧的方式消除铸态组织,达到减小变形抗力并且达到细化晶粒的效果,再采用多次冷轧与真空热处理相结合的方式来控制合金微观组织结构。
镍铂合金靶材最终平均晶粒尺寸可控制在20~200μm 之间,晶粒取向随机分布[31]。
4、镍铂合金靶材发展趋势
超高纯、高利用率与良好的溅射沉积均匀性是高质量靶材所追求的优良特性,因此在靶材基本制备方法的基础上,需要不断优化工艺提高靶材质量,具体地,从高纯化、提高磁透率(PTF)以及组织结构控制等方面提高靶材质量,将成为镍铂合金靶材制备工艺的发展趋势。
4.1 高纯化
半导体用溅射靶材对质量要求非常高,尤其是对靶材化学纯度的控制,原因是杂质的存在将严重影响靶材及相应薄膜的质量,引起溅射时异常放电等现象[32]。目前,国内外镍铂合金靶材在纯度方面的差距显著,国内所生产的镍铂合金靶材能达到4N级,而日本相关靶材厂家制备的镍铂靶可以达到5N以上。
4.2 提高磁透率
提高镍铂合金磁透率(PTF)对提高靶材利用率有着重要意义。镍含量较高的镍铂合金靶材具有较强的磁性,磁控溅射时磁场很容易被靶材所分流,从而减少穿越至表面的磁力线,使起辉或维持放电相对困难,同时也会导致比如沉积膜厚不均匀等问题,虽然减少靶材厚度(一般<3 mm)可以提高磁透率,但靶材的使用寿命短、利用率低。提高磁透率的方法主要有添加合金元素、改变靶材外形设计或者在溅射时使操作温度高于靶材的居里温度等。
4.3 组织结构控制
靶材的组织结构控制也与溅射沉积均匀性有密切关系[33]。通常溅射靶材晶粒尺寸需要控制在200μm 以下,而且晶粒尺寸越细小均匀,溅射镀膜的厚度分布越均匀,溅射速率也越快。另外,晶体织构控制对于溅射靶材十分重要,不同处理工艺的靶材有着不同的织构,对于镍以及一些面心立方金属,<200>取向的织构对于均匀镀膜与延长靶材寿命十
分有利,而大量<111>以及<113>取向织构的存在却十分不利,原因很可能是大量<111>、<113>取向织构的存在,将导致磁力线分流而不是垂直于工件与靶材空间,此时即使靶材具有较高的磁透率(>45%)和细小的晶粒尺寸(<100 μm),其镀膜均匀性以及靶材寿命都难以满足需要[34]。镍铂合金靶材的晶体织构以及织构控制工艺研究并未有文献和专利报道,镍铂合金靶材的晶体织构与靶材溅射性能的关联性研究以及织构控制等方面将是成为镍铂合金溅射靶材新的研发趋势。
5、结语
镍铂硅化物作为优良的接触材料广泛应用于半导体制造中,镍铂合金溅射靶材成为保证半导体器件性能和发展半导体技术的关键材料,其不断增长的需求量为中国贵金属靶材制造业的发展提供了机遇和挑战。
1) 不同Pt 含量的镍铂合金溅射靶材在导体制造工艺中发挥了重要作用,尤其是通过镍铂合金溅射靶材成分配比调节肖特基势垒高度以及在新的技术节点里,依次采用不同Pt 含量的镍铂合金溅射靶材来制备具有梯度结构的镍铂硅化物接触薄膜从而降低接触电阻。
2) 满足一定原子配比的镍铂合金在相应临界温度以下形成L12Ni3Pt、L10NiPt、L12NiPt3 三种有序相。Ni-Pt 合金磁性随Pt 含量增加由铁磁性向顺磁性转变,磁性转变的临界成分约为42.5%Ni(摩尔分数)。
3) 镍铂合金溅射靶材的制备方法主要采用真空熔炼法,并通过塑性加工与热处理相结合的方式来控制靶材微观组织结构。针对不同成分镍铂合金的结构与性质,溅射靶材制备需要相关制备方法以及工艺参数的调整。
4) 高纯化、靶材组织结构控制以及提高磁透率(PTF)将成为镍铂合金靶材制备工艺的发展趋势。提高靶材纯度到5N 以上,晶粒大小均匀且平均晶粒尺寸控制在200 μm 以下,是目前镍铂靶材工艺优化的目标,另外,镍铂合金靶材的晶体织构与靶材溅射性能的关联性研究以及织构控制等方面也将是镍铂合金溅射靶材新的研发趋势。
参考文献:
[1] 马勤, 阎秉钧, 康沫狂, 等. 金属硅化物的应用与发展[J]. 稀有金属材料与工程, 1999, 28(1): 10-13.
MA Q, YAN B J, KUANG M K, et al. Application anddevelopment of metal silicon[J].Rare metal materials andengneering, 1999, 28(1): 10-13.
[2] 屠海令, 王磊, 杜军. 半导体集成电路用金属硅化物的制备与检测评价[J]. 稀有金属, 2009, 33(4): 453-461.
TU H L, WANG L, DU J. Evaluation of the preparationand detection of metal silicon for semiconductorintegrated circuits[J]. Rare metals,2009, 33(4): 453-461.
[3] 黄益飞. 镍合金(NiPt、NiAl、NiY)硅化物固相反应及其与Si 肖特基接触特性研究[D]. 上海: 复旦大学,2008.
HUANG Y F. Research on nickel alloy (NiPt, NiAl, NiY)silicide solid phase reaction and its schottky contactfeatures with silicon[D]. Shanghai: Fudan University,
2008.
[4] 黄伟, 张利春, 高玉芝, 等. Ni(Pt)Si 硅化物温度稳定性的研究[J]. 固体电子学研究与进展, 2005, 25(3):422-426.
HUANG W, ZHANG L C, GAO Y Z, et al. Investigationon temperature stability of Ni(Pt)Si silicide[J]. Research& progress of SSE, 2005, 25(3): 422-426.
[5] 张青竹, 高建峰, 许静, 等. 超薄Ni0.86Pt0.14 金属硅化物薄膜特性[J]. 半导体制造技术, 2014, 39(5): 370-375.
ZHANG Q Z, GAO J F, XU J, et al. Study of ultrathinNi0.86Pt0.14 silicide film[J]. Semiconductor manufacturingtechnologies, 2014, 39(5): 370-375.
[6] 宁宝俊, 高玉芝, 赵志礼, 等. 金属硅化物-硅功率肖特基二极管[J]. 北京大学学报: 自然科学版, 1993, 29(1):71-78.
NING B J, GAO Y Z, ZHAO Z L, et al. Silicide-Si powerSchottky diode[J]. Universitatis Pekinensis: Actascientiarum naturalium, 1993, 29(1): 71-78.
[7] 陈守迎, 董军, 单维刚, 等. 肖特基二极管芯片、器件及芯片复合势垒的制备方法: CN103681885A[P].2014-3-26.
[8] THOMAS S. Composition profiles and Schottky barrierheights of silicides formed in NiPt alloy films[J]. Journalof applied physics, 1976, 47(1): 301-307.
[9] 许桂贵, 吴景, 黄志高. 表面合金化对NiPt 金属栅电极功函数的影响[J]. 福建师范大学学报, 2012, 28(3):50-53.
XU G G, WU J, HUANG Z G. The influence of surfacealloying on work function of metal gate[J]. Journal ofFujian Normal University, 2012, 28(3): 50-53.
[10] XU G, WU Q, CHEN Z, et al. Disorder and surfaceeffects on work function of Ni-Pt metal gates[J]. Physicalreview B, 2008, 78(11): 54201-54206.
[11] 王菁, 李美成, 吴敢, 等. 降低肖特基势垒高度的途径探讨[J]. 半导体光电, 2000, 21(4): 261-265.
WANG J, LI M C, WU G, et al. Research on reduction ofthe height of Schottky barriers[J]. Semiconductoroptoelectronics, 2000, 21(4): 261-265.
[12] LAUWERS A, KITTL J A, DAL M J H V, et al. Ni basedsilicides for 45 nm CMOS and beyond [J]. Materialsscience and engineering B, 2004(s114/115): 29-41.
[13] LAI J, CHEN Y W, HO N T, et al. NiPt salicide processimprovement for 28 nm CMOS with Pt(10%) additive[J].Microelectronic engineering, 2012, 92(2): 137-139.
[14] IMBERT B, PANTEL R, ZOLL S, et al. Nickel silicideencroachment formation and characterization[J].
Microelectronic engineering, 2010, 87(3): 245-248.
[15] PANCIERA F, HOUMMADA K, PERRIN C, et al.Ni(Pt)-silicide contacts on CMOS devices: Impact ofsubstrate nature and Pt concentration on the phase
formation[J]. Microelectronic engineering, 2014, 120(10):34-40.
[16] IMBERT B, GUICHET C, BONNETIER S, et al. Impactof surface preparation on nickel–platinum alloy silicidephase formation[J]. Microelectronic engineering, 2007,
84(11): 2523-2527.
[17] 邵玲, 王广欣, 赵学义. 镍铂合金靶材及其制备方法:CN1O4018120A[P]. 2014-09-03.
[18] ALPTEKIN E. NixPt1-xSi/n-Si contacts with sub-0.1 eVeffective Schottky barrier heights obtained by sulfursegregation[J]. Microelectronic engineering, 2010, 87(11):2358-2360.
[19] LUO J, QIU Z J, DENG J, et al. Variation of Schottkybarrier height induced by dopant segregation monitoredby contact resistivity measurements[J]. Microelectronicengineering, 2014, 120(6): 174-177.
[20] FRYE A, SIMON A. Nickel-silicide formation withdifferential Pt composition: US20120153359Al[P].2012-06-21.
[21] OKAMOTO H. Ni-Pt (Nickel-Platinum)[J]. Journal ofphase equilibria & diffusion, 2010, 31(3): 322.
[22] GREENHOLZ M, KIDRON A, SHIMONY U. Longrangeand short-range order in NiPt[J]. Journal of sppliedcrystallography, 1974, 7(1): 83-86.
[23] GREENHOLZ M, KIDRON A, SHIMONY U. Kineticsof ordering in NiPt [J]. Journal of materials science, 1972,7(11): 1285-1291.
[24] CHE X, LI J, DAI Y, et al. Structural stability andmagnetism of metastable Ni-Pt intermetallic compoundsstudied by ab initio calculation[J]. Science in China seriesE: Technological sciences, 2009, 52(9): 2681-2687.
[25] LU X G, SUNDMAN B, A˚GREN J. Thermodynamicassessments of the Ni-Pt and Al-Ni-Pt systems[J].Calphad, 2009, 33(3): 450-456.
[26] KUMAR U, MUKHOPADHYAY P K, SANYAL B, et al.Experimental and theoretical study of annealed Ni-Ptalloys [J]. Physical review B, 2006, 74(6): 4401.
[27] NASH P, SINGLETON M F. The Ni-Pt (Nickel-Platinum)system[J]. Journal of phase equilibria & diffusion, 1989,10(10): 258-262.
[28] 尚再艳, 江轩, 李勇军, 等. 集成电路制造用溅射靶材[J]. 稀有金属, 2005, 29(4): 475-477.
SHANG Z Y, JIANG X, LI Y J, et al. Sputtering targetsfor integrated circuit manufacturing[J]. Rare metals, 2005,29(4): 475-477.
[29] SHINDO Y. Method of manufacturing a Ni-Pt alloy:US7959782 B2[P]. 2011-6-14.
[30] 尚再艳, 张涛, 陈明, 等. 镍的电子束熔炼提纯研究[J].稀有金属, 2013, 37(1): 116-122.
SHANG Z Y, ZHANG T, CHEN M, et al. Purification ofnickel ingot prepared by electron beam melting[J]. Raremetals, 2013, 37(1): 116-122.
[31] 朱晓光, 罗俊峰, 刘红宾, 等. 一种高纯NiPt 合金靶材及其制备方法: CN104726829A[P]. 2015-06-24.
[32] 杨邦朝, 崔红玲. 溅射靶材的制备与应用[J]. 真空,2001, 6(3): 11-15.
YANG B C, CUI H L. Preparation and application ofsputtering targets[J]. Vacuum, 2001, 6(3): 11-15.
[33] 王一晴, 闻明, 郭俊梅, 等. 半导体工业用镍铂合金靶材的制备及结构研究[J]. 贵金属, 2015, 36(4): 27-31.
WANG Y Q, WEN M, GUO J M, et al. Preparation andstructure of NiPt alloy target used in semiconductorindustry[J]. Precious metals, 2015, 36(4): 27-31.
[34] ABBURI M, RAMASWAMI S. Target for use inmagnetron sputtering of nickel for forming metallizationfilms having consistent uniformity through life:
US20030015420A1[P]. 2003-01-23.
相关链接